半導體元件的封接或封裝方式分為氣密性封裝和樹脂封裝兩大類,氣密性封裝又可分為金屬封裝、陶瓷封裝和玻璃封裝。封接和封裝的目的是與外部溫度、濕度、氣氛等環境隔絕,除了起保護和電氣絕緣作用外,同時還起向外散熱及應力緩和作用。
一般來說,氣密性封裝可靠性高,但價格也高。目前由于封裝技術及材料的改進,樹脂封裝已占絕對優勢,但在有些特殊領域(軍工、航空、航天、航海等),氣密性封裝是必不可少的。
按封裝材料可劃分為:金屬封裝、陶瓷封裝(C)、塑料封裝(P)。采用前兩種封裝的半導體產品主要用于航天、航空及軍事領域,而塑料封裝的半導體產品在民用領域得到了廣泛的應用。
目前樹脂封裝已占世界集成電路封裝市場的98%,97%以上的半導體器件的封裝都采用樹脂封裝,在消費類電路和器件領域基本上是樹脂封裝一統天下,而90%以上的塑封料是環氧樹脂塑封料和環氧液體灌封料。
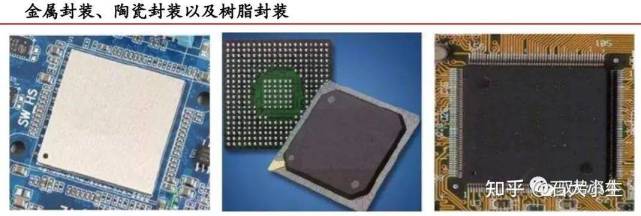
COPYRIGHT ? shuangsai.net ALL RIGHTS RESERVED. 惠州雙賽電子科技有限公司 版權所有
粵ICP備2022123491號